PCB表面处理复合工艺-沉金+OSP-深圳市FB体育

PCB表面处理复合工艺-沉金+OSP
PCB表面处理复合工艺-沉金+OSP是一种常用于高端电子产品制造领域的工艺组合。这种复合工艺结合了沉金板和OSP(Organic Solderability Preservatives)工艺,以获得更佳的综合效果。
沉金板焊点的金属间化合物(IMC)生长于镍层上,而镍锡间晶粒的机械强度稍弱于铜锡间晶粒的机械强度。沉金制程中,磷含量工艺的黑盘与高磷含量的金面不溶解的问题可能会出现,这是一个难以解决的问题。然而,沉金工艺仍然具有许多优点,例如平整的焊盘表面、金的抗氧化和低电阻率特性,以及较宽的制程窗口。
复合工艺的应用
为了兼顾机械强度和其他优点,智能手机制造业普遍采用复合型工艺,即沉金板+BGA区域焊盘采用OSP工艺。这种工艺使得BGA焊点直接生长于铜箔上,以确保其机械强度。复合型工艺制造流程相对复杂,起初应用于高端智能手机,逐渐被业界认可并流行于高端电子产品制造领域。
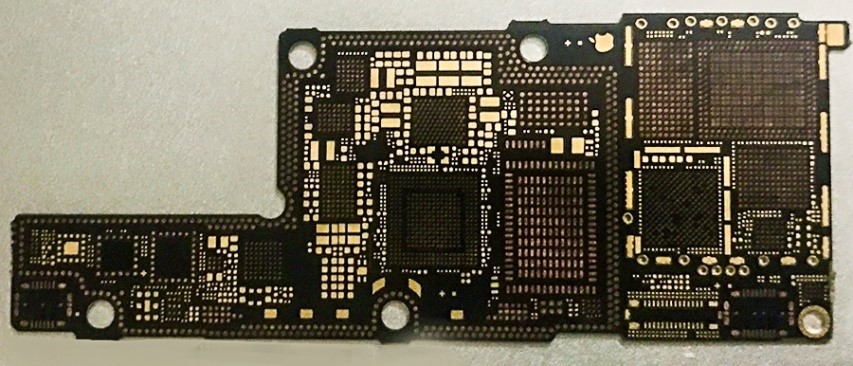
图1. PCB表面处理复合工艺:苹果手机主板;其中BGA焊盘为OSP工艺,其他区域焊盘表面处理ENIG
沉金工艺中的贾凡尼效应和金面不溶解问题
在使用沉金工艺后,金层表面的孔隙可能会暴露镍层,这可能导致在腐蚀环境中发生贾凡尼效应(Galvanic Effect),从而使镍溶解(金为阴极,镍为阳极)。镍的溶解会导致溶液中的铜离子同时还原并沉积在金表面上,导致金面皮膜的颜色变深,甚至出现金属铜。一旦沉金后的表面存在铜,氧化后的铜会导致焊盘拒焊,从而出现金面不溶解的问题。这是需要注意的细节。
总之,化学镍金板焊盘表面平整,适合密间距制程需求,可以烘烤和清洗,并具有较宽的制程窗口。金面可以用作接触面或Wire bond基面,金的不易氧化变质的特性使沉金板具有良好的焊锡性能。
沉金工艺中的常见不良情况
然而,化学镍金板也存在一些常见的不良情况,包括沉金工艺控制异常导致的黑盘(焊接后掉件、焊点强度不足)、沉金工艺导致的金层夹杂有机物(拒焊、缩锡不良)、高磷含量工艺控制异常导致金层过薄(拒焊、缩焊,焊盘未呈金色)、PCB制程异常导致电镀液残留(拒焊、缩锡、异物污染)、沉金工艺控制不良导致镍层氧化和污染(金层剥离、拒焊、缩锡)、沉金工艺控制异常导致镍层开裂和与铜层分离(焊点可靠性异常)。这些问题需要在制程中进行关注和控制。









 返回列表
返回列表



