中温焊料应用_扇出型封装焊料回流工艺优化

中温焊料应用_扇出型封装焊料回流工艺优化
扇出型晶圆级封装(FOWFLP)允许在芯片表面的外部实现更多的I/O,相比于扇入型封装带来更多优势。扇出型封装的出现突破了设备中的I/O终端限制,被视为后摩尔时代的封装解决方案。扇出封装通常是在硅晶片上切割芯片,并将已知良好的芯片精确放置在薄的重构或载体晶片上,然后对其进行模制。然后在模制区域(芯片和扇出区域)的顶部形成再分线层(RDL)和放置焊料球。
SAC305无铅焊料焊点测试
无铅焊料球的制作可以用到中温焊料如SAC305,通过BGA工艺移植到焊盘上。本文主要分析SAC305 BGA焊点的在扇出型封装的可靠性,从而获得最优的回流工艺。可靠性可以通过焊点形态,剪切强度来确认。Zhang等人为特定的扇出封装设计了PCB板,通过控制不同回流时间和峰值温度,对扇出型封装器件(72个焊点)进行了可靠性测试,研究了焊点微观结构,剪切强度和失效模式。

图1. 测试扇出型封装设备 (Zhang et al., 2022)。
不同回流工艺测试结果
Zhang等人发现SAC305焊料球在230°C峰值温度回流5s后与ENIG电极实现冶金连接形成金属间化合物。在回流5秒的时候开始出现金属间化合物,在这个阶段金属间化合物都是(Cu, Ni)6Sn5。但是厚度较薄,焊点冶金连接强度不足。(Cu, Ni)6Sn5随着时间的增加而生长,且晶粒逐渐粗化。此外,当峰值回流温度升到260°C回流10s后,(Cu, Ni)6Sn5晶粒在Sn-ENIG界面适度生长。(Cu, Ni)6Sn5晶粒形状以棒状为主且分布均匀。随着回流时间增加。脆性(Cu, Ni)6Sn5厚度大量增加会导致机械性能下降,从而增加焊点的断裂概率。

图2. 不同回流峰值温度和时间对焊接微观结构影响 (Zhang et al., 2022)。
当峰值温度为260℃,回流时间增加到20s,Sn原子扩散到含镍焊盘的表面并到达焊盘下方流动,与Cu原子反应并转化为(Cu, Ni)6Sn5。这导致焊盘体积收缩,容易从PCB上脱落。此外,在高温下,回流时间太长使得原子大量扩散到PCB表面,增加了PCB表面的应力,导致焊盘在使用过程中容易脱落, 因此焊点的可靠性较差(Zhang et al., 2022)。
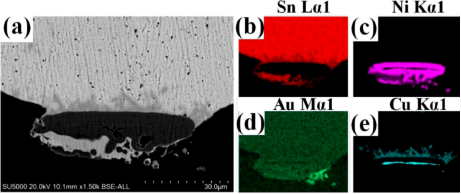
图3. 260℃峰值温度回流20s导致IMC增厚和焊盘脱落 (Zhang et al., 2022)。
可以看到在260℃峰值温度回流20s所形成的焊点在断裂后留下了发黑的焊坑。在断裂处只检测到微量Au和Ni原子,Cu和Sn原子则消耗殆尽。可能是在高温长回流时间影响下被IMC生长所消耗。如果回流温度继续升高到260℃以上,焊盘过度溶解,脱落风险进一步提高。

图4. 260℃峰值温度回流20s所形成的焊点失效模式 (Zhang et al., 2022)。
总结
过高回流温度和过长回流时间还会造成焊点氧化,导致更多孔洞形成。这严重降低了焊点的可靠性。此外,焊盘也会被进一步溶解,从而减小焊点剪切强度。因此Zhang等人认为扇出型封装最佳回流焊工艺温度是时长为260℃和10s。在这个回流参数下形成的SAC305焊点剪切强度达到了216.41N。
深圳市FB体育能制造无铅中温锡膏和低温锡膏,例如锡银铜锡膏,锡铋银锡膏等,能够替代微间距BGA焊料球使用。欢迎与我们联系进行进一步了解。
参考文献
Zhang, S.Y., Duan, R., Xu, S.W., Xue, P.F., Wang, C.Q., Chen J.S., Paik, K.W. & He, P. (2022). “Shear performance and accelerated reliability of solder interconnects for fan-out wafer-level package”. Journal of Advanced Joining Processes, vol.5.









 返回列表
返回列表



